? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? 臺積電3nm進度超前背后�����!關(guān)鍵突破性技術(shù)揭秘
? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ? ?2021-02-23? ?青野云麓
2021-02-23 來源:芯東西 作者:心緣
在2021年國際固態(tài)電路會議(ISSCC)的開幕演講中���,臺積電董事長劉德音以《揭秘創(chuàng)新未來》為主題�,談及許多引領(lǐng)芯片發(fā)展的創(chuàng)新技術(shù)����。
半導(dǎo)體創(chuàng)新是驅(qū)動現(xiàn)代科技進步的關(guān)鍵。劉德音認為��,半導(dǎo)體制程微縮腳步并未減緩�����,集成電路的晶體管密度��、性能和功耗仍在持續(xù)進步��,理想情況下��,硬件創(chuàng)新應(yīng)像編寫軟件代碼一樣容易�����。
劉德音不僅透露了臺積電先進3nm工藝的研發(fā)進度提前,而且討論了包括EUV���、新晶體管����、新材料����、芯片封裝、小芯片�����、系統(tǒng)架構(gòu)等一系列通向未來的突破性半導(dǎo)體技術(shù)����。在這些技術(shù)驅(qū)動下,芯片工藝節(jié)點路線圖能保持每兩年大約2倍的能效性能提升���。
芯東西對此次演講的重點信息進行系統(tǒng)梳理,全文如下:
?

一��、7nm:半導(dǎo)體史上的重要分水嶺
劉德音在演講中說��,從2018年開始量產(chǎn)的7nm邏輯技術(shù)是半導(dǎo)體史上的一個分水嶺���,標志著當時世界上最先進的半導(dǎo)體技術(shù)首次被所有半導(dǎo)體公司廣泛使用��。
這一分水嶺時刻帶來了跨廣泛應(yīng)用領(lǐng)域的變革產(chǎn)品�����,包括5G芯片��、GPU��、網(wǎng)絡(luò)��、游戲和汽車��。
例如�����,AMD EYPC Gen2處理器結(jié)合了新的芯片架構(gòu)和7nm技術(shù)���,為數(shù)據(jù)中心提供了創(chuàng)紀錄的低功耗高性能計算����。與上一代相比���,其7nm芯片性能提高了2倍以上��,或功耗降低50%���。
采用7nm工藝的NVIDIA A100 AI加速器,其性能提升20倍甚至更多���,效果更加顯著���。這種創(chuàng)新的數(shù)據(jù)中心解決方案可以大幅降低總擁有成本,占用空間更小��,并提供更高效的計算��。
如今臺積電7nm技術(shù)已應(yīng)用于市場上超過150種產(chǎn)品�����。截至去年8月20日�����,臺積電7nm芯片出貨量突破10億大關(guān)����,足夠覆蓋13個曼哈頓城市街區(qū)。
“這是技術(shù)應(yīng)用民主化的趨勢�����,我們將繼續(xù)穩(wěn)步推進芯片級擴展��、EUV增強��,以及各種器件增強技術(shù)��,如高遷移率溝道��?����!眲⒌乱粽f�。

?
二�、3nm:臺積電進度超預(yù)期
劉德音特別提到,或許有人認為芯片技術(shù)的進步正在放緩�����,但臺積電的產(chǎn)品數(shù)據(jù)顯示��,在相同速度或速度增益���、相同的功耗和邏輯密度下���,功耗降低的速度保持不變。
據(jù)他透露�����,臺積電3nm進展順利����,甚至比預(yù)期進度超前一些��。
臺積電此前公開數(shù)據(jù)顯示���,與目前最先進的商用5nm芯片相比���,3nm芯片的邏輯密度將提高75%���,效率提高15%,功耗降低30%���。
其3nm芯片將于今年晚些時候試產(chǎn)��,預(yù)計將在2022年下半年開始商業(yè)化生產(chǎn)����。
劉德音說���,產(chǎn)學(xué)界一直密切合作����,通過創(chuàng)新的晶體管結(jié)構(gòu)����、新材料�����、新系統(tǒng)架構(gòu)和3D封裝等技術(shù)來維系超越3nm的技術(shù)進步�����。
下面���,讓我們來看看其中的一些創(chuàng)新。
?
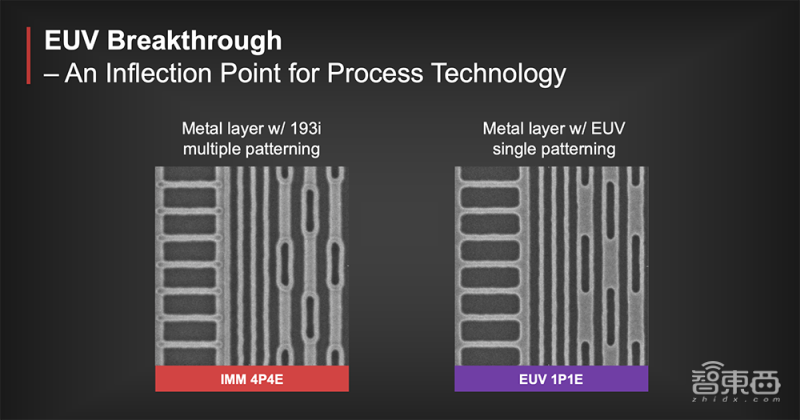
三��、EUV:電源功率提高至350W
光刻技術(shù)是推動晶體管密度提升的關(guān)鍵技術(shù)�����。近年來��,極紫外(EUV)光刻技術(shù)的創(chuàng)新突破了193nm浸入式光刻技術(shù)的分辨率瓶頸。
相比采用多重圖案化���、多次曝光方式���,EUV光刻技術(shù)能使用較少層數(shù)的光罩,提供了更高的圖案保真度����,并減少了過程復(fù)雜性和缺陷率��,從而縮短周期時間����、提高生產(chǎn)效率。
可以公平地說����,隨著EUV光刻技術(shù)的引入,分辨率將不再像過去那樣限制設(shè)備技術(shù)����。相反,光刻吞吐量及其他半導(dǎo)體挑戰(zhàn)上升為熱門話題�。
如何抵消EUV能耗的增加,并將模式的總成本降低到與可控模式相當甚至更低的水平�����,是至關(guān)重要的。
EUV吞吐量的一個關(guān)鍵指標是電源功率��。一個EUV光束發(fā)出后��,只有不到2%的光線能保留下來���,要降低成本���,則需要光源足夠強,中心焦點功率達到250W�����。
而據(jù)劉德音透露�����,臺積電EUV光源技術(shù)穩(wěn)步發(fā)展�����,現(xiàn)在其電源功率已達到350W,可支持5nm芯片量產(chǎn)����,并為3nm、2nm的發(fā)展鋪平了道路���。
?
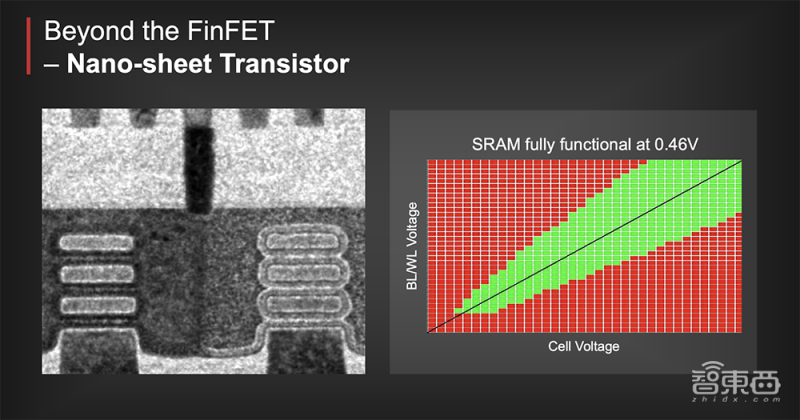
四、晶體管:5nm引入新材料�,2nm轉(zhuǎn)向GAA
隨著時間推移�����,光刻成本逐漸降低��,新的晶體管結(jié)構(gòu)和新材料也出現(xiàn)一些重大突破�。
出于量產(chǎn)考慮,臺積電在5nm和3nm節(jié)點均采用鰭式場效應(yīng)晶體管(FinFET)結(jié)構(gòu)�,但在材料上有所創(chuàng)新。
臺積電在5nm節(jié)點引入一種高遷移率溝道(high mobility channel�,HMC)晶體管,將鍺整合到晶體管的鰭片(Fin)中,而導(dǎo)線也利用鈷與釕材料來持續(xù)挑戰(zhàn)物理極限�����。
在3nm制程之后���,臺積電將在其2nm制程中采用更復(fù)雜的環(huán)繞柵極晶體管(gate-all-around�,GAA)的納米片(nanosheet)結(jié)構(gòu)�����,提供相較FinFET更強的載流能力��,持續(xù)優(yōu)化芯片性能和功耗�。
與前幾代技術(shù)相比,納米片晶體管實現(xiàn)了減少漏端引入的勢壘降低(DIBL效應(yīng))和更好的亞閾值擺幅(subthreshold swing)��,以提高電路性能�����,為SRAM帶來更低的供電電壓��,可提供0.46V的可靠快取操作�。
隨著芯片上快取的需求越來越高��,能將耗電降低到0.5V以下�����,將有助于改善芯片的整體功耗�����。
臺積電已宣布將在臺灣新竹建立一家晶圓廠���,生產(chǎn)2nm芯片,但該公司尚未公布2nm制程的確切研發(fā)時間表���。
?

五���、DTCO:提升晶體管密度新思路
在過去幾代技術(shù)中,臺積電采用了設(shè)計-技術(shù)協(xié)同優(yōu)化(Design & Technology Co-Optimization���,DTCO)的概念���,或者將DTCO與固有縮放相結(jié)合的方法��,來實現(xiàn)所需的邏輯密度和降低成本���。
DTCO將原本各自孤立的設(shè)計與制造思維轉(zhuǎn)為一種合作體制,能維持每一節(jié)點邏輯密度穩(wěn)步提升1.8倍��,芯片尺寸縮小35%至40%�。這種模式為系統(tǒng)級芯片(SoC)設(shè)計的重要領(lǐng)域帶來進展。
?

六�、新材料:低維材料取得重大突破
臺積電也在尋找新的領(lǐng)域繼續(xù)進軍�。我們在許多技術(shù)領(lǐng)域看到了有前途的研究。例如��,低維材料����,包括六方氮化硼(hexagonal boron nitride�����,hBN)等2D層狀材料��,在前端和后端都有很多機會�。
據(jù)劉德音了解�����,低維材料近年來已經(jīng)取得了重大突破���。例如����,臺積電與多家學(xué)術(shù)團隊合作成功地在2英寸晶圓襯底上外延生長單晶六方氮化硼(hBN)單層薄膜���。這項研究發(fā)表在2020年3月的國際學(xué)術(shù)期刊《自然》上��。
碳納米管(CNT)也是未來晶體管的潛在候選者之一。臺積電兩個月前在IEDM上發(fā)表的一篇論文展示了其在碳納米管溝道上的突破�。臺積電研發(fā)了獨特的工藝流程來為碳納米管提供high-K電介質(zhì)等效柵極氧化物�����,適合于10nm柵極長度的晶體管���。
?

此外���,還有銅、硅鍺����、半氧化物及更多的新型材料將被引入晶體管制造,且并不局限于前端設(shè)備��。
七�、小芯片:面向特定領(lǐng)域的更優(yōu)方案
先進的晶體管技術(shù)不僅提高性能和能效,而且還提供了必要的空間來增加功能����,并在架構(gòu)、應(yīng)用和軟件方面進行創(chuàng)新���。
特定領(lǐng)域的GPU架構(gòu)和應(yīng)用處理器需要額外的晶體管來執(zhí)行專門的功能�。今天,最先進的單顆GPU有超過500億個晶體管�����。
在系統(tǒng)層面���,臺積電的InFo����、CoWoS�����、SoIC技術(shù)等多種解決方案���,為封裝系統(tǒng)的晶體管數(shù)量增加至3000億開辟了道路�。
劉德音不打算詳細介紹臺積電的3DFabric技術(shù)是如何工作的���。他想指出的是�����,芯片業(yè)已不再只關(guān)注單個芯片�����,而是開始將單個芯片集成到系統(tǒng)中���。這也被稱之為小芯片(chiplet)。
最近小芯片已經(jīng)成為一個非常熱門的話題�����。劉德音說��,在小芯片變得“很酷”之前����,就已經(jīng)有很多人投入相關(guān)研發(fā)。
?

SoC不再是唯一的最佳系統(tǒng)�����,多個小芯片封裝在一起將發(fā)揮越來越重要的作用�。這些小芯片可以在各自技術(shù)方面實現(xiàn)最優(yōu)化,從而提高性能����、能效、密度��、成本和功能��。
這可以概念化為特定領(lǐng)域技術(shù)(domain specific technology)的方法��。特定領(lǐng)域的技術(shù)根據(jù)應(yīng)用的特性����,以適當?shù)某杀緸榉庋b系統(tǒng)提供適當?shù)男阅芩健?/span>
八、系統(tǒng)集成:I/O密度增長10000倍成為可能
劉德音強調(diào)3D系統(tǒng)結(jié)構(gòu)是讓技術(shù)朝著正確方向發(fā)展的關(guān)鍵推手����。臺積電SoIC的最新進展包括3DFabric,該技術(shù)可將多個芯片堆疊封裝在一起����。
下圖展示了一個通過臺積電SoIC和低溫鍵合將12個裸晶堆疊的例子�����,總厚度不到600μm����,右側(cè)是該12層堆疊SoIC的X光影像��。
“看看這完美的排列……”劉德音在展示3D堆疊結(jié)構(gòu)的X光影像感嘆道�����。
這里�,增加芯片之間的I/O密度是增加峰值帶寬和減少傳輸能耗的關(guān)鍵���。
今天的計算系統(tǒng)面臨著帶寬不足的問題�����。最近的數(shù)據(jù)顯示��,峰值吞吐量平均每兩年增長1.8倍����,而峰值帶寬每兩年增長僅約1.6倍。
顯然�,帶寬不足的問題仍然存在。最有效的規(guī)范是增加I/O數(shù)量���,幸運的是���,I/O互連密度還有很大的發(fā)展空間。
在過去的10年里���,芯片互連密度快速發(fā)展����,通過使用SoIC及其未來的擴展��,包括單片三維集成�、系統(tǒng)集成封裝,密度有可能再提高10000倍�����。
為了提高系統(tǒng)吞吐量����,我們需要更多的晶體管����、更多的內(nèi)存�,以及晶體管和存儲器之間更多的互連。
另一方面�����,內(nèi)存從一端到另一端在系統(tǒng)堆棧中進行了優(yōu)化���,以提高能效。
劉德音僅展示了從封裝到單片3D集成技術(shù)來實現(xiàn)這一點的幾個例子��,可以看到�����,這些技術(shù)越來越多地融合在一起�����。
片上存儲也使存內(nèi)計算成為一種新的計算方式��,無論各種技術(shù)方法有何不同,能效都是最重要的計算目標��。
為了滿足高性能計算對內(nèi)存帶寬及移動應(yīng)用對低功耗內(nèi)存訪問的需求��,降低內(nèi)存訪問帶來的能耗也將是核心優(yōu)化方向����。
臺積電認為需要用高級封裝技術(shù)將邏輯芯片和內(nèi)存芯片集成方面進行創(chuàng)新,還需解決散熱問題��,為未來高密度集成芯片開發(fā)熱解決方案����。
?

結(jié)語:先進技術(shù)走向民主化
總之��,在過去的15年里����,芯片行業(yè)已經(jīng)交付了新的性能水平����、更低功耗的計算�,實現(xiàn)了每兩年大約2倍的能效��、性能提升���。
劉德音說�����,目前正大規(guī)模生產(chǎn)的臺積電最新5nm技術(shù)�����、3nm技術(shù)節(jié)點均在實現(xiàn)同樣節(jié)奏的進步��。
隨著芯片產(chǎn)學(xué)界繼續(xù)合作,在包括材料����、設(shè)備、電路設(shè)計�����、系統(tǒng)封裝�����、架構(gòu)設(shè)計在內(nèi)的多種創(chuàng)新驅(qū)動下,這種趨勢正延續(xù)向未來�����。
歷史已經(jīng)證明���,技術(shù)一開始掌握在少數(shù)人手中����,但最終其成果將由大多數(shù)人享用�。他認為培育一個廣泛的設(shè)計生態(tài)系統(tǒng)是非常重要的,它可以降低進入門檻��,釋放出大量的創(chuàng)新���。
“理想情況下���,硬件創(chuàng)新應(yīng)該像編寫軟件代碼一樣容易。當這種情況發(fā)生時�,我們將看到應(yīng)用程序和系統(tǒng)設(shè)計的又一次復(fù)興。我們才剛剛開始�����。”劉德音說�。